*목차*
1. Flip Chip Bonding(플립칩 본딩) 공정 이란?
2. Flow of Flip Chip Bonding(플립칩 본딩 공정의 흐름)
1. Flip Chip Bonding(플립칩 본딩) 공정 이란?
반도체 후공정인 패키징(Packaging Process)에서
'Flip Chip Bonding(플립칩 본딩)' 공정은
Flip Chip = Chip을 뒤집어
Bonding = 붙인다.
라는 뜻이에요.
이름 그대로 Die Chip을 뒤집어서 Wafer 또는 Chip에 붙이는 공정이에요.
반도체 전공정(Semiconductor Front-End Process)가 끝난 Chip에는
전기적 신호가 흐를 수 있는 회로가 만들어져 있어요.
그런데 원하는 동작을 하는 반도체 Device를 만들기 위해서는 하나의 개별 Chip을
또 다른 회로가 그려진 Chip 또는 외부 회로와 연결할 필요가 있어요.
Flip Chip Bonding은 Chip의 회로를 외부와 연결하는 공정 중 하나에요.
Flip Chip Bonding 공정을 진행하기 위해서는
Bump(범프, 접속단자)라는 전기적 신호가 잘 통하는 금속 물질의 기둥 형태 구조물을
Chip 회로(Pattern)에 맞춰서 Chip 위에 형성해야돼요.
그리고 Bump를 Chip과 Chip(또는 Wafer) 사이에 두고 Pattern에 맞춰서
열(Heat) 및 압력(Pressure)를 가해 접합시켜요.(Thermal Compression Bonding)
여기서 Bump는 일종의 접프선, 도전의 역할을 해서 2개 Chip 회로를 연결해줘요.
Chip의 회로를 외부와 연결하는 또 다른 공정으로
'Wire Bonding(와이어 본딩)'이라는 공정이 있는데
이 공정은 전기 회로에서 전선을 납땜으로 연결하는 것처럼
가느다란 금속 Wire를 쭉 이어서 연결해요.
때문에 Chip Pattern 표면에 Wire를 붙이기 위한 Metal Pad를 크게 만들어야 되고
Wire 끼리 닿지 않도록 Metal Pad를 위치를 잘 설계해서
Wire가 지나가는 공간을 만들어야 돼요.
때문에 반도체 회로가 많아지고 Pattern도 작아지면서(소형화, 집적화)
Wire 크기로는 한계가 있어요.
대신 Flip Chip Bonding 공정에서는
Chip 패턴 위에 ㎛ 단위 크기의 Bump를 올리고
Chip 면과 면으로 Pattern을 맞춰서 다이렉트로 연결해 버리니
같은 크기의 Chip에서 Wire Bonding 방식 보다 많은 회로를 만들고 연결할 수 있어요.
소형화, 집적화에 더 유리한 공정이에요.
추가로 반도체 Device는 계속 작아지는데
Bump의 크기로도 한계가 있는데요.
그래서 최근에는 Bump 없이 SiO2나 Metal Film로 Chip을 그냥 붙여버리는 방식인
'Hybrid Bonding(하이브리드 본딩)' 방식을 사용해요.
AI가 주목 받으면서 'HBM(High Bandwidth Memory)'의 필요로
하이브리드 본딩이 중요해지고 있어요.
그래서 학회에서도 자주 언급이 되는 것 같아요.
(Hybrid Bonding에 대해서도 나중에 공부해서 정리해봐야겠어요.)
2. Flow of Flip Chip Bonding(플립칩 본딩 공정의 흐름)
Flip Chip Bonding은 보통 Wafer 위에 Die Chip을 붙이는데요.(Chip to Wafer, C2W)
상황에 따라 Die Chip 끼리 붙이기도 해요.(Chip to Chip, C2C)
2.1 Cleaning(세정)
-. 먼저 Wafer 또는 Chip 표면을 Cleaning해서 패턴 위에 Particle을 제거해요.
만약 Particle이 있는 상태에서 Bonding이 되면
해당 위치에 접합이 제대로 되지 않아 회로가 연결이 안되고
심할 경우 Particle 부분에서 Crack이 생길 수 있어요.
2.2 Flux 도포 → Pick Up(Flip) → Aline(정렬)
-. Substrate에 해당하는 Chip(또는 Wafer) 위에 Flux를 도포해요.(Reflow 용)
그리고 Bonding할 Chip의 패턴 전면이 바닥을 향하도록 뒤집어서(Flip) Pick Up 해요.
Chip을 잡을 때는 진공(Vacuum)으로 고정해요.
Chip 하나는 뒤집혀서 위에 매달리고, 다른 Chip은 바닥에 나란히 놓인 상태에서
Pattern을 Align(정렬) 해줘요.
Align하는 방법은
Flip Chip Bonding 장비에 위쪽과 아래쪽을 동시에 볼 수 있는
마이크로스코프(Microscope)가 있어서
Chip이 Loading된 상태에서 Chip 사이로 Scope가 들어가서 비추면
2개 Chip 패턴을 화면에 동시에 겹쳐서 볼 수 있어요.
2개 패턴을 맞춰가면서 Align을 해요.
2.3 Reflow + Bonding(Thermal Compression)
-. Metal 물질로 이루어진 Bump는 공기 중에 노출되면 산소와 반응하여
Bump 표면에 얇은 '자연산화막층(Native Oxide Layer)'가 생겨요.
산화막층은 전기 신호 전달을 방해하고 Bump의 접합력도 저하시켜요....
Reflow(리플로우) 공정은
Flux를 도포하고 가열하여 자연산화막을 제거하는 공정이에요.
Flux를 도포하고 Bump와 Metal pad가 접촉한 상태에서 열(Heat)과 압력(Pressure)를 가하면
Reflow 공정과 함께 Bump가 Bonding이 돼요.
보통 Reflow와 Bonding을 동시에 진행하는데
경우에 따라서 Bonding 공정을 진행하기 전에 따로 Reflow 공정을 하기도 해요.
이때는 산화막을 제거하면서 Ball Bump 형태를 만들기 위해서 해요.
2.4 Flux Cleaning
-. Reflow를 위해서 도포하였던 Flux를 Bonding이 완료된 후에 제거해요.
Solvent Spray와 같은 걸로 제거를 해요.
Reflow에 사용하는 물질에 따라 Cleaning하지 않고 그대로 쓰는 경우도 있어요.
2.5 Under-fill & Curing
-. Chip이 Bump로만 붙어있는 상태에서는 외부 충격에 손상되거나 심하면 떨어질 수도 있어요. 충격이 아니더라도 외부 습도나 온도 같은 환경에 손상될 수 있어요.
그래서 Epoxy와 같은 '경화수지'를 Bonding이 완료된 Chip의 Bump 사이사이 공간에 주입하고(Underfill) 가열해서 경화시켜서(Curing) 단단하게 고정하면서 Chip을 보호해요.
Underfill, Curing 고정으로 Flip Chip Bonding 공정이 마무리돼요.
**공부하면서 정리해봤는데 오류가 있으면 댓글로 수정 부탁드려요.

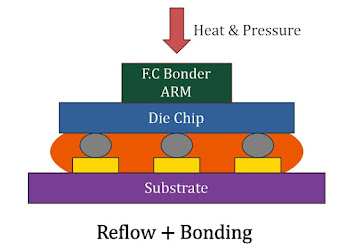





댓글 없음:
댓글 쓰기