1. 열팽창 계수 차이(CTE Mismatch)로 인한 물체의 Bending, Warpage
2. CTE Mismatch로 발생하는 열응력(Thermal Stress)
3. CTE Mismatch로 인한 Wafer Warpage
반도체 공정을 진행하면 Wafer에 'Bending(굽힘)' 또는 'Warpage(뒤틀림)'가 발생하는데
보통 온도 변화에 의해서 생길 수 있어요.
물체의 온도가 상승하거나 하락하면
물체의 크기(부피)가 팽창하거나 수축해요.
그런데 서로 다른 물질로 이루어진 물체 2개가 딱 붙어있는 상태에서
온도가 변하면 물질마다 '열팽창 계수(CTE)'가 다르기 때문에
열 변형량의 차이로 물체는 굽어지거나 뒤틀리게 돼요.
**이전 포스팅에서 열팽창 계수에 대해 정리했는데 필요하시면 참고하세요~
반도체 IC를 만들기 위해서는 Wafer 위에 여러가지 물질을 쌓아 올리는데
그러면 Layer 마다 CTE 차이가 생겨서
판판했던 Wafer가 휘거나 뒤틀릴 수 있어요.
꼴 반도체 공정뿐만 아니라 다른 분야에서도 생길 수 있어요.
이번 포스팅에서는
'열팽창 계수 차이(Coefficient of Thermal Expansion Mismatch)로 인해서
물체의 Bending, Warpage가 어떻게 발생하는지 공부하고 정리해 봤어요~
1. 열팽창 계수 차이(CTE Mismatch)로 인한 물체의 Bending, Warpage
-. 아래 그림처럼 CTE 값이 서로 다른 물질의 A막대와 B막대가 딱 붙어있다고 했을 때
(아무리 힘을 가해도 떨어지지 않는다고 가정)
A막대 물질의 CTE 값이 B막대 물질 보다 커요. (CTE : A>B)
위 물체가 열을 받고 온도가 상승하면 부피가 팽창 하는데
붙어있는 2가지 막대의 CTE가 달라서
동일안 온도 변화량에도 열팽창 정도가 달라요..
CTE가 상대적으로 더 큰 A막대가 더 팽창해요.
만약 2가지 막대가 붙어있지 않고 그냥 놓여있다면
각 물질의 CTE만큼 길이가 개별로 팽창해요.
하지만 2가지 막대가 딱 붙어서 고정되어 있다면
두 막대는 서로 부피 변화에 영향을 주게 돼요.
물체의 온도가 상승했을 때
CTE가 상대적으로 큰 A막대는 많이 팽창하려고 하는데
CTE가 상대적으로 작은 B막대는 적게 팽창하려고 해서
결국 물체는 CTE가 낮은 B막대 쪽으로 휘게 돼요.
반대로 온도가 하락한다면
CTE가 큰 A막대는 많이 수축하려고 하는데
CTE가 작은 B막대는 적게 수축하려고 해서
CTE가 큰 A막대 쪽으로 휘게 돼요.
2. CTE Mismatch로 발생하는 열응력(Thermal Stress)
-. '열팽창 계수 차이(CTE Mismatch)'로 발생하는 Bending으로 인해서
'열응력(Thermal Stress)'가 발생해요.
**이전 포스팅에서 '열변형률, 열응력'에 대해서 정리해봤는데 필요하시면 참고하세요.
물체에 온도 변화가 생기면 변형이 일어나야 되는데
그러지 못하고 형태가 고정되면서 발생하는게 '열응력(Thermal Stress)'에요.
그런데 CTE가 서로 다른 2가지 물질이 딱 붙어있는 막대에 온도 변화가 생기면
CTE가 큰 물질 쪽은 많이 변하려고 하지만
CTE가 작은 물질 쪽은 적게 변하려고 하면서 Bending이 생기게 돼요.
여기서 CTE가 큰 물질은 CTE가 작은 물질에 의해서 변하지 못하게 막히고
CTE가 작은 물질은 CTE가 큰 물질에 의해 더 변하도록 당겨져요.
이렇게 CTE가 서로 다른 물질이 서로 간섭하면서 '응력(Stress)'이 발생해요.
2.1) 온도가 상승했을 때
-. CTE가 큰 A막대는 팽창이 막히는 방향, '압축 응력(Compressive Stress)'이 발생하고
CTE가 작은 B막대는 팽창하도록 당겨지는 방향, '인장 응력(Tensile Stress)'이 발생해요.
2.2) 온도가 하락했을 때
-. CTE가 큰 A막대는 수축이 막히는 방향, '인장 응력(Tensile Stress)'이 발생하고
CTE가 작은 B막대는 수축하도록 당겨지는 방향, '압축 응력(Compressive Stress)'가 발생해요.
'압축 응력'과 '인장 응력'은 힘의 방향이 반대에요.
반도체 공정에서 만약 Wafer 위에 올라간 물질의 CTE가 Si Wafer와 차이가 크면 Stress가 커지고 심하면 Wafer가 깨질 수도 있어요.
CTE Mismatch로 Wafer가 받는 Stress를 줄이기 위해서
응력 방향이 다른 물질을 쌓아가면서 상쇄 시키기도 해요.
3. CTE Mismatch로 인한 Wafer Warpage
-. 증창 공정을 하다보면 Wafer의 온도가 상승한 상태에서 증착이 되다가
공정이 끝나면 온도가 상온으로 하락해요.
온도가 하락하는 과정에서 물질의 CTE 차이로
Wafer에 Bending 또는 Warpage가 발생해요.
Wafer의 Warpage가 아래면 쪽으로 볼록할 경우(Edge가 위로 올라갈 경우)
= Smiling type (스마일링 타입)
Wafer의 Warpage가 위면 쪽으로 볼록할 경우(Edge가 아래로 내려갈 경우)
= Crying type(크라잉 타입)
이라고 불러요.
보통 Metal 물질은 CTE 커요.
그래서 Si Wafer 위에 증착을 하면 온도가 상승한 상태에서 증차이 되고
공정이 끝나면 온도가 하락하는데 이때 Metal Layer 쪽으로 수축이 많이 되면서
Smiling type의 Warpage가 생겨요
Warpage가 심하게 생기면
후속 공정에서 어려움이 발생할 수 있어요.
Robot Pick 문제나 공정의 Uniformity가 나빠질 수 있고 Wafer가 깨질 수도 있어요.
Wafer Warpage 문제는 Memory 반도체 성능을 높이기 위해서
회로가 수직 방향으로 늘어나고, Layer가 많아질 수록 중요해지는 것 같아요.
또 Wafer 위에 다른 Chip을 Bonding하고 Epoxy Compound를 사용하는 등
Wafer가 두꺼워지는 Package 공정에도 Warpage 수준 관리가 중요해요.
**공부하면서 정리해봤는데 오류가 있으면 댓글로 알려주세요.




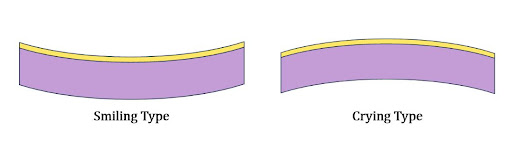



댓글 없음:
댓글 쓰기